構造形成機構の探求
[1-1] Si酸化現象の微視的機構の解明
(Phys. Rev. Lett. 81, 5936 (1998); Jpn. J. Appl. Phys. 38, L971 (1999); Jpn. J. Appl. Phys. 43, 8223 (2004); Jpn. J. Appl. Phys. 45, 694-699 (2006); Phys. Rev. B 77, 115356 (2008) 等)
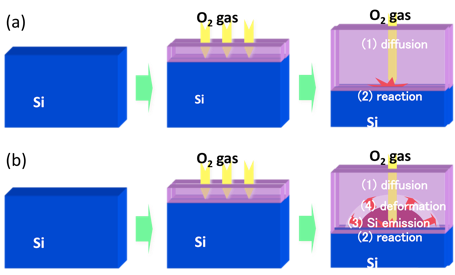
Si酸化の微視的機構。(a) 従来の理解、(b) 新しい理解

温度降下時のSi結晶成長中欠陥の形成と窒素複合体による空孔凝集抑制
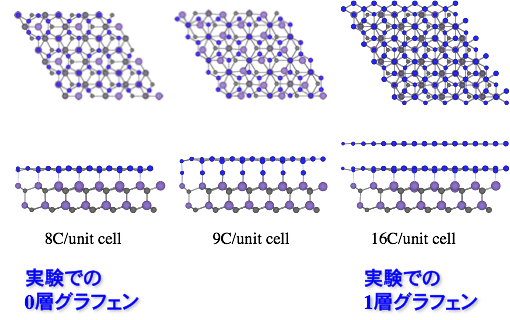
SiC(0001)面上エピタキシャルグラフェンの界面成長機構
酸化現象は原子輸送の物理を内包する複雑な現象である。シリコンの熱酸化現象は、シリコンを700℃から1100℃の高温で酸素雰囲気の中に置くことで表面がシリコン熱酸化膜に変化する現象であり、半導体デバイス開発の目的で詳しくその現象が調べられている。従来、O2分子が酸化膜中を拡散して酸化膜/Si界面に到達、ここで酸化反応が起こるとする、2段階過程説が提唱されていたが、酸化膜厚が数nm以下では従来説で説明できない急激な酸化反応が発生(初期増速酸化現象)することが実験的にわかっていた。我々は第一原理計算を用いて、酸化中に界面から酸化膜中へSiが溶け出す過程が存在することを明らかにし、初期増速酸化現象の起源を解明、数々の実験で証拠も示し、教科書を書き換えた。さらに、立体ナノ構造の酸化過程の解明に向けて理論を拡張、酸化膜の粘流動性の考慮も重要であることを明らかにした。
シリコン熱酸化過程はMOSFETのゲート絶縁膜形成プロセスであるため、その機構の詳細理解は作成したMOSFETの動作特性に直結するため、この研究の基礎的・産業的インパクトは大きく、特にMOSFETにおけるhigh-k絶縁膜の開発において実際に利用され、第一原理計算を用いた研究が産業界に役立った希有な例である。
本研究の遂行にあたり、第一原理計算と統計力学に基づくマクロな拡散反応理論を組み合わせるという研究手法的な工夫も行っている。
本成果は、MRSポスター賞、応用物理学会論文賞等を受賞し、また「応用物理分野の発展史マップ」(応用物理学会2010年3月)において論文が重要論文として引用されている。
[1-2] Si固相成長機構に関する研究
(Appl. Phys. Lett. 76, 3718 (2000); J. Appl. Phys. 100, 113513-1-7 (2006) 等)
Si結晶成長時に生じる空洞の抑制手法を、第一原理計算を用いて検討。窒素添加が原子空孔を強力に捕獲することで、空洞の形成を抑制する機構を解明。CZ-Siでは、原子空孔を捕獲した窒素がさらに酸素を周囲に析出させることを促進することを示した。そして、第一原理計算で求めた各種欠陥の反応エネルギーから、それら欠陥濃度の温度依存性を求め、窒素添加により空洞の成長温度が50℃ほど下がり、空洞サイズの縮小と駆動密度の増加を予言。実験結果を見事に説明することに成功した。
本研究の遂行にあたり、第一原理計算と統計力学に基づく反応の熱平衡理論を組み合わせるという研究手法的な工夫も行っている。
[1-3] SiC熱分解グラフェン成長機構に関する研究
(Phys. Rev. B 77, 075413 (2008); Appl. Phys. Express 2, 065502 (2009); Jpn. J. Appl. Phys. 50, 095601 (2011): Phys. Rev. B 86, 085417 (2012): Phys. Rev. B 88, 235405 (2013). 等)
グラフェンは、層状物質グラファイトから、蜂の巣状にCが並んだ原子層一層を取り出したものである。SiCを1000℃以上の高温に加熱すると表面からSi原子が脱離してC原子が豊富になり、SiC表面に2次元物質グラフェンが成長する。グラフェンは極めて薄いためSiC表面のどこに何層できているのか判別するのは極めて難しいが、低速電子線顕微鏡(LEEM)の入射エネルギーを変化させて反射率を測定することで、その変化からグラフェンの層数を同定する手法の基礎理論を構築、実験による形成過程のその場観察を可能とした。
そうした実験の結果、SiC(0001)表面上のグラフェンが層数制御しやすいことが明らかになった。そこでこの表面上でのグラフェン成長機構を第一原理を用いて検討。新しいグラフェン層が常に界面から現れ、古いグラフェン層は界面から遠ざけられる、界面成長型であることを解明。そして、SiC基板との相互作用とその歪みがC凝集物がグラフェンとして成長することに欠かせないことを示した。さらに、グラフェン初期成長におけるステップの役割を明らかにすることで、高Si分圧と高温がSiC(0001)面上での品質の良いグラフェン成長のポイントであることを明らかにした。
本研究の遂行にあたり、第一原理計算と統計力学に基づく化学ポテンシャル理論を組み合わせるという研究手法的な工夫も行っている。
[1-4] CVD法によるグラフェン・hBN形成機構機構の研究
(e-J. Surf. Sci. Nanotechnol. 18, 70 (2020); Appl. Phys. Express 13, 065007 (2020))
高温下でCu基板上をCH4やBH3NH3SiC雰囲気中に置くと、表面にグラフェンや単原子層hBNが形成される。この手法は、グラフェン基板を作る手法としてSiC加熱法以上に注目を浴びており、盛んに研究開発が成されている。我々は特に、グラフェンとhBNが面内の一枚のシートにつながった横方向ヘテロ構造や、グラフェンとhBNが重なった縦方向二層ヘテロ構造の実験的な作り分けに成功。作り分けができた理由として、Hの効果に着目している。
本研究の遂行にあたり、第一原理計算と統計力学に基づく化学ポテンシャル理論を組み合わせるという研究手法的な工夫も行っている。
[1-5] SiCの熱酸化機構の研究
(J. Appl. Phys. 113, 184312 (2013). 等)
SiCを熱酸化すると、CはCOxとして揮発し、SiがSiO2となって酸化膜が形成される。このとき、どのような仕組みでSiO2膜の成長速度が決定しているのか、また酸化膜中にはCOxがどのように残存しているのか、界面固定電荷密度はどのように決まっているのか、は、SiCをMOSFET型のパワーデバイス応用する場合に重要な問題となっている。
COxの拡散機構について第一原理計算を用いて検討し、拡散障壁高さの評価を行っている。
[1-6] 圧縮歪み下SiO2-x中の自己拡散の研究
(Jpn. J. Appl. Phys. 57, 06KD01 (2018); Jpn. J. Appl. Phys. 58, 111004 (2019).)
近年のMOSFETの立体化に伴いSiナノ構造を酸化してSiO2膜を形成すると、体積膨張して形成されるSiO2膜界面ではSiが放出されて組成がO不足に偏るだけで無く圧縮歪みが加わるため、SiO2膜中のSiやOの自己拡散は大きな変化が起こることが予想される。実際我々の検討で、大幅な自己拡散の促進が起こりうることが明らかになった。
本研究の遂行にあたり、第一原理分子動力学計算と統計力学に基づく解析を組み合わせるという研究手法的な工夫も行っている。
[1-7] SiO2中O欠陥の安定性と拡散に対する歪み効果の研究
SiO2のO欠陥はSi MOSFETの故障の原因となる酸化膜中固定電荷やゲートリーク電流、絶縁破壊の原因となることが知られている。近年のMOSFETの立体化に伴い酸化膜に様々な歪みが加わるようになることから、その安定性や拡散に対する歪み効果の検討を行っている。
本研究の遂行にあたり、第一原理計算と統計力学に基づく化学ポテンシャル理論を組み合わせるという研究手法的な工夫も行っている。
[1-8] 2次元物質の欠陥の安定性の研究
(Jpn. J. Appl. Phys. 56, 025201 (2017); Jpn. J. Appl. Phys. 57, 125202 (2018). )
hBNやTMDCといった2次元物質をFETに利用する際には、欠陥の存在が特性劣化の原因となる。どのような欠陥ができるのか、電子のフェルミエネルギーによってその形成エネルギーがどのように変化するのか、さらには積層して二層にした場合にそれがどのように変化するのか、検討を行った。
本研究の遂行にあたり、第一原理計算と統計力学に基づく化学ポテンシャル理論を組み合わせるという研究手法的な工夫も行っている。





